当前位置:
X-MOL 学术
›
Precis. Eng.
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
Material removal rate model for chemical–mechanical polishing of single-crystal SiC substrates using agglomerated diamond abrasive
Precision Engineering ( IF 3.6 ) Pub Date : 2024-04-03 , DOI: 10.1016/j.precisioneng.2024.04.002 Pengfei Wu , Ning Liu , Xue Li , Yongwei Zhu
Precision Engineering ( IF 3.6 ) Pub Date : 2024-04-03 , DOI: 10.1016/j.precisioneng.2024.04.002 Pengfei Wu , Ning Liu , Xue Li , Yongwei Zhu
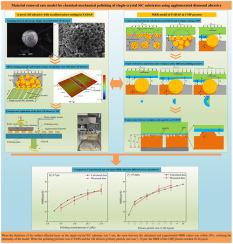
|
Material removal mechanisms are essential for the selection of polishing slurries and parameter optimization of chemical–mechanical polishing (CMP) processes. This study established a material removal rate (MRR) model for CMP of single-crystal SiC substrates using a fixed agglomerated diamond (AD) abrasive pad (FADAP). The distribution of the polishing pressure between the AD abrasive and FADAP matrix was examined, and the influence of the abrasive and polishing parameters on the MRR was revealed. Furthermore, single-factor experiments were conducted to validate the rationality of the MRR model. The experiments demonstrated that when the thickness of the surface-affected layer of the single-crystal SiC substrate in the MRR model was set to 5 nm, the error between the calculated and experimental values of the model could be controlled to within 20%. This result experimentally verified the validity of the MRR model and its associated assumptions. Moreover, the MRR of the CMP process of a single-crystal SiC substrate reached 36.26 μm/h with a polishing pressure of 27.6 kPa and an AD abrasive primary particle size range of 7–10 μm. Therefore, the feasibility of efficiently processing single-crystal SiC substrates using an FADAP was theoretically confirmed.
中文翻译:

使用团聚金刚石磨料对单晶 SiC 基材进行化学机械抛光的材料去除率模型
材料去除机制对于抛光浆料的选择和化学机械抛光 (CMP) 工艺的参数优化至关重要。本研究建立了使用固定团聚金刚石 (AD) 磨料垫 (FADAP) 进行单晶 SiC 基板 CMP 的材料去除率 (MRR) 模型。研究了 AD 磨料和 FADAP 基体之间的抛光压力分布,揭示了磨料和抛光参数对 MRR 的影响。此外,通过单因素实验验证了MRR模型的合理性。实验表明,当MRR模型中单晶SiC衬底表面变质层厚度为5 nm时,模型计算值与实验值的误差可控制在20%以内。这一结果通过实验验证了 MRR 模型及其相关假设的有效性。此外,在抛光压力为27.6 kPa、AD磨料初级粒径范围为7-10 μm的情况下,单晶SiC衬底的CMP工艺的MRR达到36.26 μm/h。因此,从理论上证实了使用FADAP高效加工单晶SiC衬底的可行性。
更新日期:2024-04-03
中文翻译:

使用团聚金刚石磨料对单晶 SiC 基材进行化学机械抛光的材料去除率模型
材料去除机制对于抛光浆料的选择和化学机械抛光 (CMP) 工艺的参数优化至关重要。本研究建立了使用固定团聚金刚石 (AD) 磨料垫 (FADAP) 进行单晶 SiC 基板 CMP 的材料去除率 (MRR) 模型。研究了 AD 磨料和 FADAP 基体之间的抛光压力分布,揭示了磨料和抛光参数对 MRR 的影响。此外,通过单因素实验验证了MRR模型的合理性。实验表明,当MRR模型中单晶SiC衬底表面变质层厚度为5 nm时,模型计算值与实验值的误差可控制在20%以内。这一结果通过实验验证了 MRR 模型及其相关假设的有效性。此外,在抛光压力为27.6 kPa、AD磨料初级粒径范围为7-10 μm的情况下,单晶SiC衬底的CMP工艺的MRR达到36.26 μm/h。因此,从理论上证实了使用FADAP高效加工单晶SiC衬底的可行性。



























 京公网安备 11010802027423号
京公网安备 11010802027423号